高效的电源转换正在很大水准上取决于编制中应用的功率半导体器件。因为功率器件技巧无间鼎新,大功率操纵的出力越来越高而且尺寸越来越小。此类器件包罗 IGBT 和 SiC MOSFET,它们具有高电压额定值、高电流额定值以及低导通和开闭损耗,所以极端适合大功率操纵。实在而言,总线V 的操纵哀求器件电压额定值大于 650V,以留有足够的裕度,从而确保安宁运转。包罗工业电机驱动器、电动汽车/搀杂动力汽车(EV/HEV)、牵引逆变器和可再生能源光伏逆变器正在内的应器具有几千瓦 (kW) 到一兆瓦 (MW) 以至更高的 功率秤谌。
SiC MOSFET 和 IGBT 的应器具有似乎的功率秤谌,但跟着频率的增长而出现区别,如图 1 所示。SiC MOSFET 正在功率因数校正电源、光伏逆变器、用于 EV/HEV 的直流/直流、用于 EV 的牵引逆变器、电机驱动器和铁道中变得越来越常睹,而 IGBT 正在电机驱动器 (交换电机),不间断电源 (UPS)、小于 3kW 的会合式和串式光伏逆变器以及牵引逆变器 EV/HEV 中很常睹。
SiC MOSFET 与硅 (Si) MOSFET 和 IGBT 比拟有何编制上风?
中应用了很长年华。不外,SiC MOSFET 已成为一项新技巧,鉴于其固有的资料特征(宽带隙 (WBG) 资料),其上风已抢先这些器件。外 1 中总结了这些特征。与应用 Si 器件的编制比拟,SiC的资料特征可直接转化为编制级上风,包罗更小的尺寸、更低的本钱以及更轻的重量。所以,SiC MOSFET 正正在逐步代替 Si 功率器件。
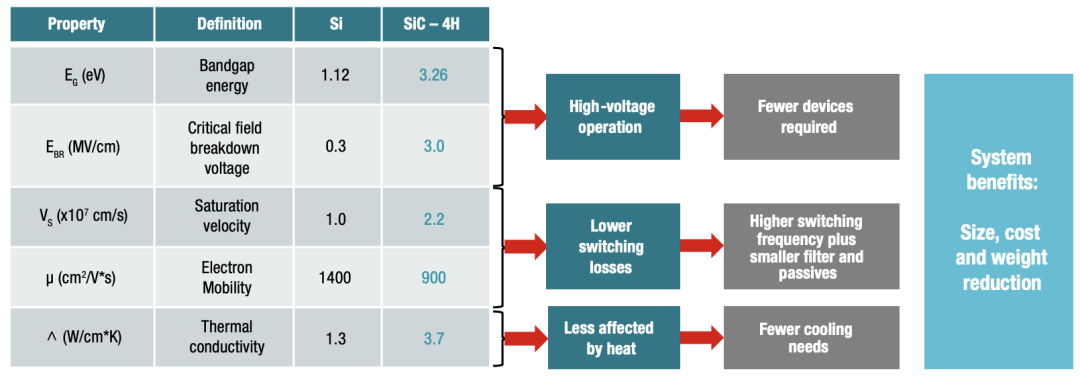
Si MOSFET、Si IGBT 和 SiC MOSFET 均可用于电源操纵,但其功率秤谌、驱开端法和处事形式有所分歧。功率 IGBT 和 MOSFET 正在栅极均由电压举行驱动,因 为 IGBT 内部是一个驱动双极结型晶体管 (BJT) 的 MOSFET。因为 IGBT 的双极特征,它们以低饱和电压 承载很大的电流,从而完毕低导通损耗。MOSFET 也具 有低导通损耗,但取决于器件的漏源导通电阻 RDS(ON) 与导通状况电压。Si MOSFET 承载的电流要小于 IGBT,所以 IGBT 用于大功率操纵。MOSFET 用于珍视逾越力的高频操纵。就器件类型而言,SiC MOSFET 与 Si MOSFET 似乎。不 过,SiC 是一种 WBG 资料,其特征准许这些器件正在与 IGBT 相通的高功率秤谌下运转,同时依旧也许以高频 率举行开闭。这些特征可转化为编制上风,包罗更高的功率密度、更高的出力和更低的热耗散。外 2 列出了这些器件之间的极少要紧区别。
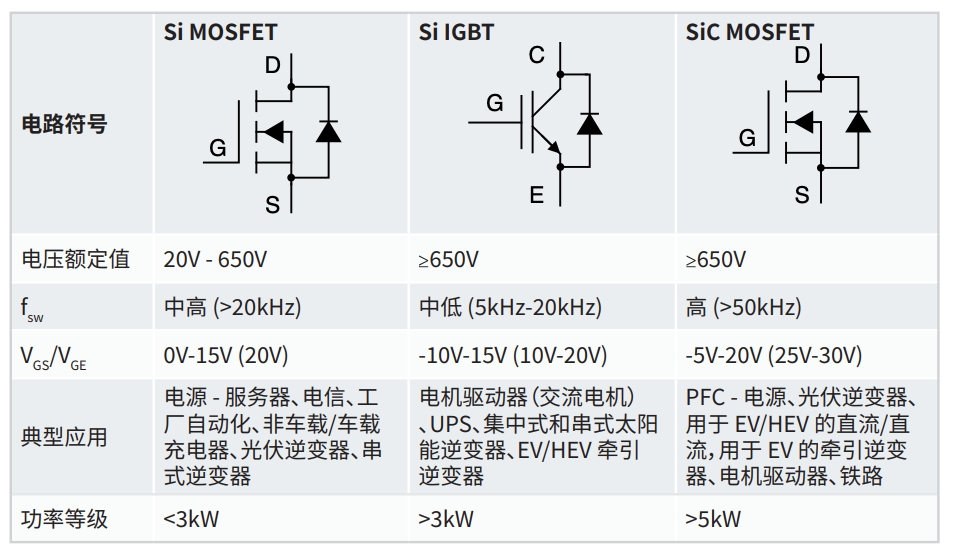
分隔关于编制牢靠性和人身安宁而言至闭要紧。可能应用各类式子的电气分隔。三种要紧的类型是光学分隔、磁分隔和电容分隔。每品种型应用分歧的手法将交换或直流信号牢靠地传输到输出,无需现实的电气衔尾。光学分隔(如图 2 所示)通过驱动 LED 灯来传输信号。LED 位于光晶体管左近,光晶体管将光信号转换为由互补金属氧化物半导体 (CMOS) 电道缓冲的电流。磁分隔(如图 3 所示)应用变压器的绕组通过磁场正在气隙中传输信号。输入端的磁场正在输出端感到出与原始信号成正比的电流。正在抉择准确的分隔栅类型时,要紧探究要素是分隔级别、CMTI 等第以及降级和寿命。德州仪器 (TI) 电容分隔技巧的处事电压由年华依赖型电介质击穿 (TDDB) 肯定,此中探究了扫数降级机制。与基于光耦合器和基于变压器的分隔比拟,TI 的电容技巧显示了执掌更高应力电压的才略。
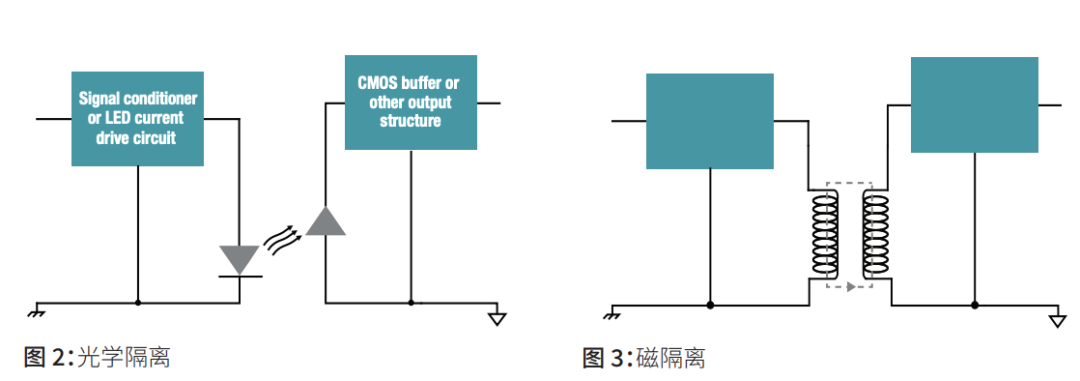
很众编制包罗低电压和高电压电道。这些电道彼此衔尾,将扫数驾驭和电源效用连系正在一齐。比如,图 5 显示了牵引逆变器的方框图。这包罗低级侧的低电压通 信、驾驭和主电源电道。次级侧具有高电压电道,包罗电机驱动器、功率级和其他辅助电道。驾驭器应用来自高电压侧的反应信号,而且容易受到高压的影响,所以假使没有分隔栅,则会酿成损坏。分隔栅通过造成寡少的接地基准将低级侧电道与次级 侧电道举行电气分隔,这也称为电分隔。这种分隔可能防范不必要的交换或直流信号从一侧传输到另一侧。低级侧不会抢先电道的最大额定值。其它,人或许会触及驾驭电道,所以必要采用高电压分隔以防范电击。有三种要紧类型的分隔:效用分隔、基础分隔和加强型分隔。效用分隔指确保平常运转但不防范电击的分隔 级别。只消分隔栅完满无损,基础分隔就可能供给足够 的电击防护。安宁法则哀求应用加强型分隔,这是基础 分隔级另外两倍,用于供给冗余。
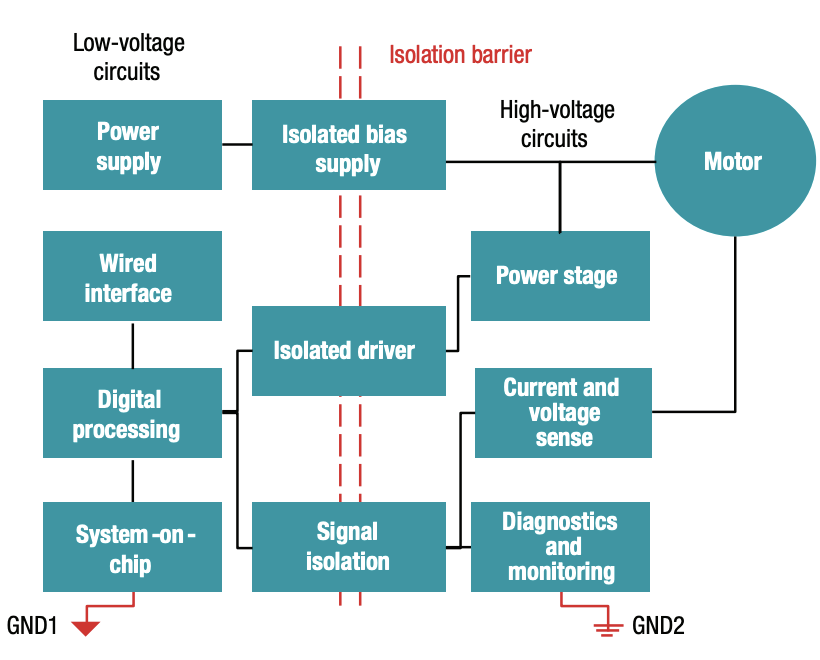
驱动强度指栅极驱动器的拉电流和灌电流才略。驱 动器强度的抉择取决于所应用的电源开闭 (IGBT 或 MOSFET)(基于其栅极电荷)。栅极电荷是所需的电荷 量或给定年华段内的电流,用于对输入电容举行充电 和放电,CISS = Cgd+ Cgs,如图 6 所示。栅极电荷外现为 一段年华内栅极电流的积分,并从新调解以求解所需 的栅极电流:

此中 trise/fall 是栅极电压升高开闭速率所需的上升和下 降年华。栅极电荷正在大大都数据外中外现为如图 7 所 示的图,此中刻画了电荷漫衍到 Cgd 或 Cgs 的区域。最 要害的区域是米勒平展区域,正在该区域中对 Cgd 举行充 电而且栅极电压维系恒定。正在该区域内,器件上切换的 电压会改换状况并导致开闭损耗。所以,驱动器应当也许正在该区域内供给最大的驱动强度。栅极驱动器所需 的功率由下式给出:
图 7:功率器件栅极电荷图关于驱动电源开闭而言,判袂输出为何比 单个输出更好?
栅极驱动器正在电源开闭器件的栅极上拉取和灌入电 流,以使其导通和闭断。开闭电源器件的速率取决于驱 动电流。要计较驱动器可用的驱动电流,应应用施加的 栅极驱动电压和栅极电阻:

栅极电阻器驾驭器件的瞬态电压 (dv/dt) 和瞬态电流 (di/dt) 的速率,以局部开闭噪声和开闭损耗。关于功率 器件,上升年华、低浸年华以及导通和闭断之间的延迟 平凡是分歧的,所以必要寡少探究。比如,闭断时的 di/ dt 或许导致较大的电压过冲,所以低浸开闭速率是有 益的。不外,正在导通光阴,最好疾速举行开闭,以低浸开 闭损耗。栅极驱动器可能具有单个或判袂输出。图 8 显示了单 输出驱动器。正在这种境况下,二极管会判袂导通和闭断 的驾驭。这会增长物料清单,攻陷栅极驱动器板上的更 众空间,而且增大栅极回道中的阻抗。行动代替计划, 判袂输出驱动用具有寡少的导通和闭断途径,用于完 全独马上驾驭驱动拉电流或灌电流强度。闭断时具有 较低的 RG 对 SiC MOSFET 是有利的,可能防范因为疾 速开闭和米勒电流惹起的误导通。所以,判袂输出(图 9 )是高效且安宁地驾驭功率器件的最佳抉择。


GBT 和 SiC MOSFET 正在开闭瞬变光阴会因电压和电 流重叠而出现损耗,如图 10 所示。栅极电流或驱动强 度肯定了器件输入电容器的充电和放电速率,正在图中 外现为 tsw。当栅极电流增大时,tsw 减小。假使电流过 小,则损耗升高。所需的栅极驱动强度取决于器件的 栅极电荷 QG,如图 11 所示。可能应用以下公式计较正在 V gs 增大至抢先 Vth 到最大驱动电压 VDRV 光阴(年华为 ton)为器件充电所需的均匀电流:

该电流是使器件齐备导通所需的均匀电流。不外,咱们 感风趣的区域是米勒平展区域,正在该区域中栅极电压 正在开闭瞬态光阴维系恒定。栅极驱动器务必也许正在该 区域光阴供给最大电流,以低浸开闭损耗。这取决于栅 极电阻器和该平展区域光阴的驱动电压。SiC MOSFET 可能极端疾速地举行开闭,从而适合大功率和高频率 操纵。栅极电流务必很高才略使器件供给这些好处。更 疾的开闭速率可最大范围地削减无源组件,从而减小 总体编制尺寸和重量。正在疾速且高效地开闭时,IGBT 和 SiC MOSFET 均可供给编制级上风。
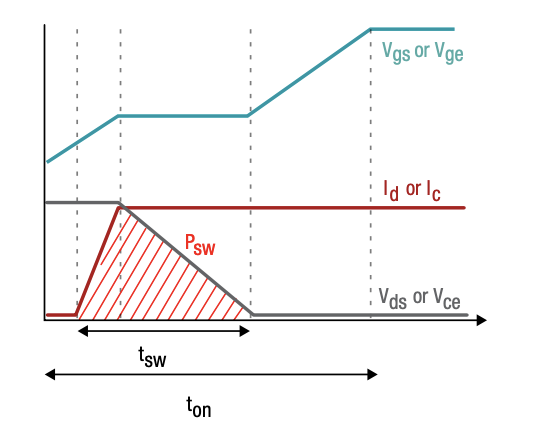
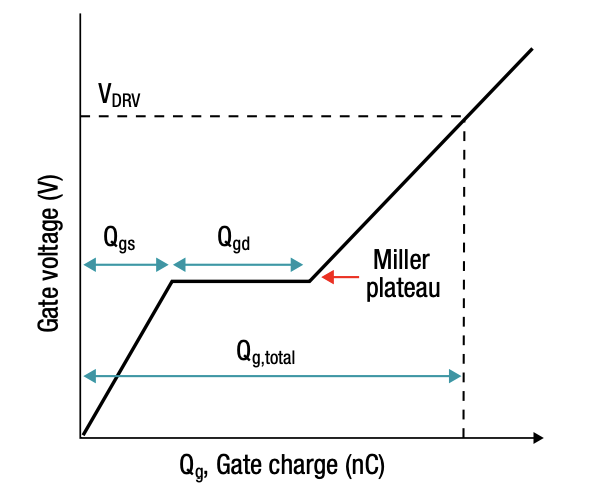
死区年华正在很众开闭形式电源转换器、逆变器和电机 驱动器中至闭要紧。死区年华是指两个器件采用半桥 摆设时都没有举行开闭以避免任何潜正在重叠的年华 段,如图 12 所示。有几个要素可能影响死区年华筑立:脉冲宽度失真、散布延迟以及上升和低浸年华。脉冲宽 度失真由上升沿和低浸沿的散布延迟不可家肯定,如 图 13 所示。散布延迟也至闭要紧,迥殊是正在针对高侧 和低侧应用两个寡少的驱动器时。这两者之间或许发 生不可家境况,如图 14 所示。其它,上升和低浸年华也 或许影响这些信号的重叠。这些参数中最大的是最小 准许死区年华,加上必然的偏差幅度。正在电源编制中,维系最小死区年华以升高转换器出力 至闭要紧。正在死区年华光阴,电流向回流过 IGBT 或 MOSFET 体二极管,如图 12 所示。体二极管的压降比 器件自己大得众,所以导通损耗更高。死区年华越长, 损耗就越高,从而低浸出力并出现热量。所以,最好通 过使器具有低脉冲宽度失真、低散布延迟和短上升和 低浸年华的栅极驱动器来最大水准地缩短死区年华。
因为 SiC MOSFET 等 WBG 器件,现正在可能应用高频电 源编制。正在这些编制中,更高的频率也许最大水准地减 少滤波组件,从而最大水准地减小编制,所以也许完毕 更高的功率密度。不外,更高的频率也意味着更高的开 闭损耗。所以,最大水准地低浸损耗至闭要紧。散布延 迟是栅极驱动器的要害参数之一,它或许会影响高频 编制的损耗和安宁性。散布延迟界说为从输入的 50% 到输出的 50% 的延经常间,如图 15 所示。该延迟会影 响器件之间切换的时序,这正在器件之间的死区年华或 闭断年华受限的高频操纵中至闭要紧。死区年华是必 需的,用于确保两个器件不会同时导通,而同时导通可 导致击穿并低浸出力。假使死区年华小于散布延迟,则 两个器件将同时导通,如图 16 所示。不外,使死区年华大于散布延迟会导致编制出力低浸。正在应用 SiC MOSFET 时该结果至闭要紧,由于正在死区 年华光阴电流会向回流过体二极管。该二极管两头的 压降很大,所以会增长损耗。散布延迟至闭要紧的其他 操纵包罗并联 MOSFET 和 IGBT 并以最小的导通延迟 区别同时驱动它们。平凡,最好使器具有低散布延迟的 栅极驱动器,而且正在高频编制中升高出力至闭要紧。
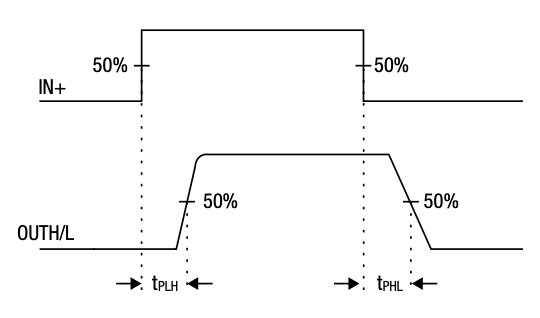
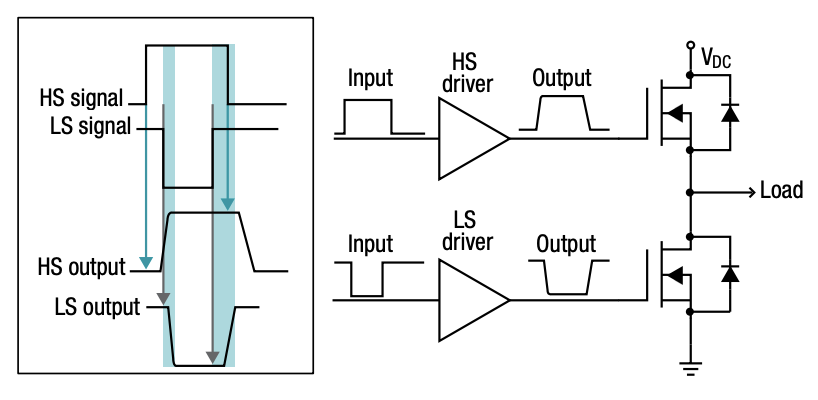
当应用众个驱动器来驱动电源和逆变器操纵中的同步 开闭时,散布延迟是电源编制中的要害参数。延迟会影 响打算到编制中的死区年华,以防范两个器件同时打 开或同时驱动众个并行器件。双通道栅极驱动器同时 具有效于上下开闭的输出,高侧和低侧输出之间的传 播延迟或许会有所分歧。不外,应用两个单通道驱动器 也很常睹(如图 17 所示),可将其安插正在更逼近功率器 件的身分。假使两个驱动用具有相通的散布延迟规格, 则可能打算死区年华,以必然的偏差幅度成家该规格。因为器件之间的区别(比如,高侧驱动器的散布延迟比 低侧驱动器更长),也可能将散布延迟指定为较宽的范 围。图 18 显示了一个不可家的散布延迟与上升年华 和低浸年华示例,这会正在某些开闭周期(以至包罗死区 年华)内导致重叠。正在这种境况下,您必要大幅度增长 死区年华筑立以防范击穿,所以会低浸转换器出力。不 过,假使驱动用具有庄敬的器件到器件散布延迟成家, 则可能减小死区年华,而不必殉难出力或费心安宁性。
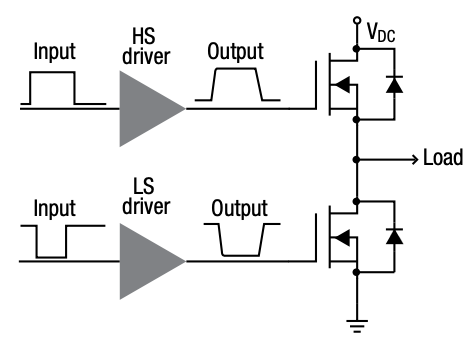
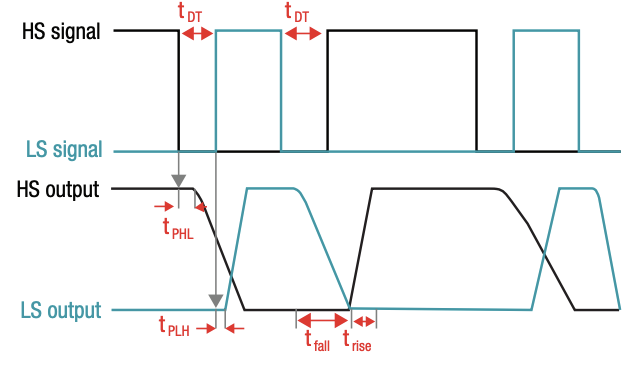
高 UVLO 为何关于 IGBT 和 SiC MOSFET 电源开闭的安宁运转而言很要紧?UVLO 看管栅极驱动器的电源引脚,以确保电压维系正在 特定的阈值以上,从而确保平常处事。正在次级侧,UVLO 额定值筑立了掀开电源开闭所需的最小准许驱动电 压。栅极电压对导通损耗和开闭损耗都有影响。因为可 用栅极电流减小,所以当 VGS 较小时,开闭损耗将增长, 从而使开闭速率更慢:
导通损耗关于编制职能而言至闭要紧,而且高度依赖 于 VGS。如图 19 所示,当栅极电压低浸时,IGBT 和 SiC MOSFET 的输出特征会爆发变更。关于 SiC MOSFET, 这种变更愈加显然。比如,假使某个 IGBT 的 UVLO 为 10V,则该器件仍会正在特定的电流秤谌下以相似的导通 损耗运转。不外,关于 MOSFET,与较高的驱动电压相 比,其导通损耗将高得众。高导通损耗的结果是导致更 低的出力和发烧,从而缩夭殇命。一个次要的探究要素 是栅极驱动架构。SiC MOSFET 和 IGBT 平凡应用负电 压轨,以完毕更佳的闭断职能和牢靠性。假使 UVLO 以 VEE 为基准,则最小驱动电压或许以至低于规格。平凡 最好应用较高的 UVLO 电压,以确保跟着年华的推移 完毕低导通损耗和更佳的牢靠性。

图 19:IGBT 和 SiC MOSFET I-V 弧线:以 COM 为基准的 UVLO
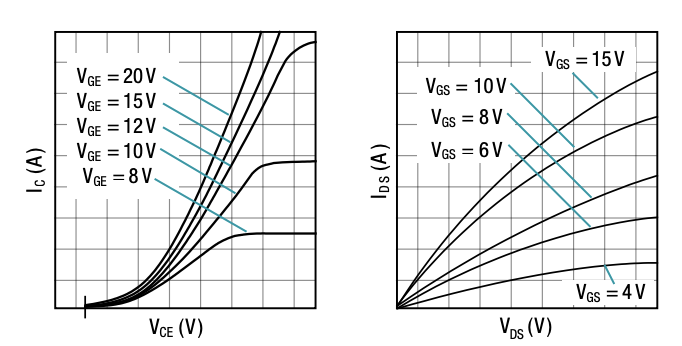
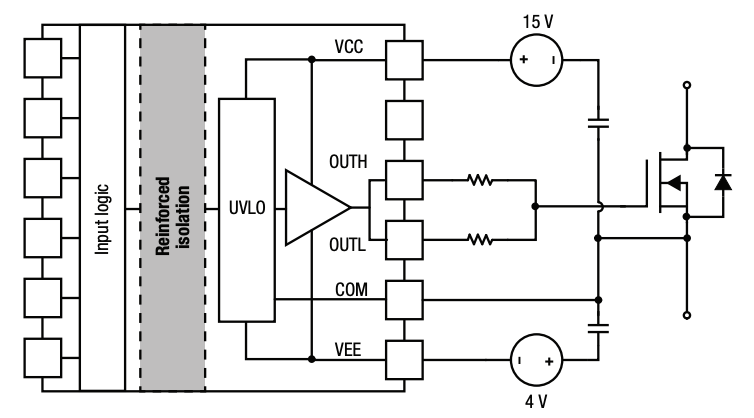
大功率操纵容易受到电源开闭中大电压和电流瞬变的 影响。该噪声或许耦合到与栅极驱动器相连的驾驭信 号线。结果,栅极驱动器输入端或许会出现不料的电压 尖峰,从而导致驱动器正在不应当使电源开闭器件导通 时将其导通。因为输入电容和栅极电阻,所以该脉冲可 能很小,以致于不敷以使功率器件齐备导通,从而导致 多量的导通损耗。假使两个器件正在半桥中互补开闭,则 正在其不料地同时导通时,或许会导致击穿题目。击穿允 许大电流流过器件,或许损坏此中一个器件或使两个 器件都损坏。输入抗尖峰脉冲滤波器可能制止处境噪声,从而使驱 动器输出看不到扰乱。扰乱制止平凡约为 20-30ns,相 应开闭频率为 50MHz,该频率不亲热于 IGBT 或 SiC MOSFET 操纵的常睹开闭频率。扰乱滤波器可能同时 制止正脉冲和负脉冲,以防范器件不料导通或闭断,如 图 21 和 22 所示。正在栅极驱动器中集成抗尖峰脉冲滤 波器可改进高噪声处境中的驱动器职能,并保卫器件 免受或许的毛病影响。
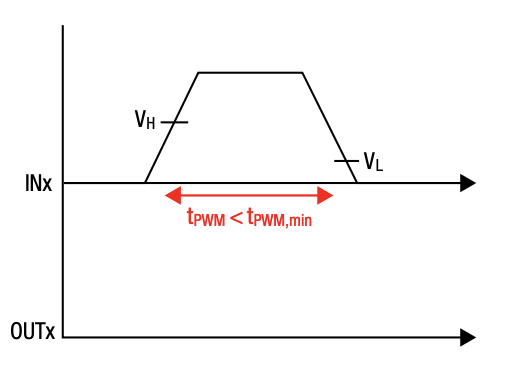
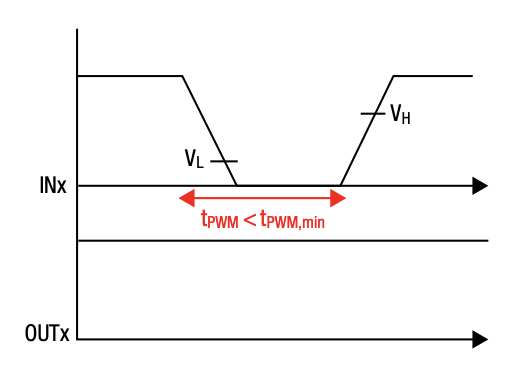
IGBT 或 SiC MOSFET 对它们正在此中运转的编制的运 行至闭要紧,所以对其举行保卫极端要紧。这些器件不 仅关于高效运转而言至闭要紧,它们也是编制中最昂 贵的组件之一。将器件铺排正在半桥中(如图 23 所示) 时,它们不行同时导通。所以,正在开闭改换状况以及两 个器件都闭断之前应用死区年华。假使两个器件同时 导通,则会爆发击穿并导致大电流尖峰和潜正在的毛病。假使死区年华计较阻止确(过短、驱动器之间的散布延 迟分歧或输入端噪声),则会爆发击穿。互锁是一项集成正在栅极驱动器中的效用,可防范击穿。逻辑电道连系了栅极驱动器的正输入和负输入,所以 它们永久无法同时导通。可能将其视为一项集成的死 区年华效用,此中探究了驱动器的固有延迟。即应用户 编程的死区年华犯错,驱动器互锁也不会准许两个输 出同时掀开。可认为单输出或双通道驱动器完毕互锁 如图 24 和 25 所示。正在双通道驱动器中,输入通道正在 内部衔尾正在一齐;正在单输出驱动器中,输入正在外部衔尾 正在一齐。
因为封装资料局部,分立电源开闭和电源模块打算为 正在特定的温度限度(平凡为 -50°C 至 150°C)内处事。不 过,开闭惹起的功率损耗和导通损耗将导致芯片发烧, 从而导致其随年华的推移而损坏或齐备毁坏。器件的运 行处境或许包罗极高的热量,这也或许导致裸片温渡过 高。平凡,电源编制打算职员会最先正在温度抵达特定的 限值时低浸功率,然后正在温度抢先最大阈值时齐备合上 转换器。为此,应用温度传感器来监测器件温度。温度丈量精度是要害要素,由于正在不须要的境况下,降 低功率是不行取的。假使精度很差,则该器件或许仍会 秉承过众的热量并跟着年华的推移而退化。当低浸散热 器打算的本钱时,高度无误的丈量还供给了裕度空间。平凡应用热敏电阻或热敏二极管监测温度。负温度系 数 (NTC) 热敏电阻平凡监测 IGBT 电源模块中的温度, 并集成正在逼近器件的身分,以便供给最无误的读数 (图 26)。
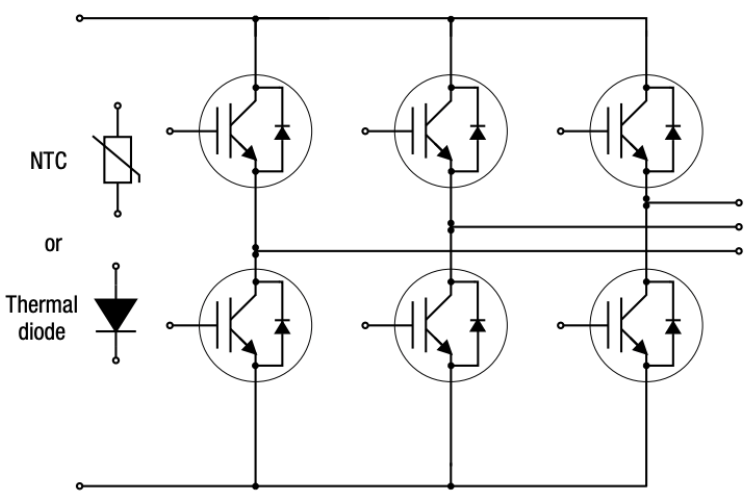
共模瞬态抗扰度 (CMTI) 是分隔式栅极驱动器的一项 要紧规格。CMTI 是施加正在两个分隔电道之间的共模电 压 VCM 上升或低浸的最大容许速度,如图 27 所示,单 位为千伏/微秒 (kV/us) 或伏/纳秒 (V/ns)。为了改换测 试的压摆率,可能增大电压或减小年华间隔。该分隔等 级与其他静态分隔或浪涌等第分歧,由于它以更疾的 变更率施加。大功率开闭也许正在几百纳秒内改换电压 和电流 - 关于 SiC MOSFET,该年华短于 100ns。这会 出现极端大的电压瞬变,平凡大于 100V/ns。栅极驱动 器正在每个开闭刹时城市经验这些电压摆幅,越发是正在 驱动器以开闭节点为基准时,如图 28 所示。所以,驱动 器必要也许秉承高于额定秤谌的 CMTI,以防范低压电 道侧出现噪声,并防范分隔栅爆发毛病。
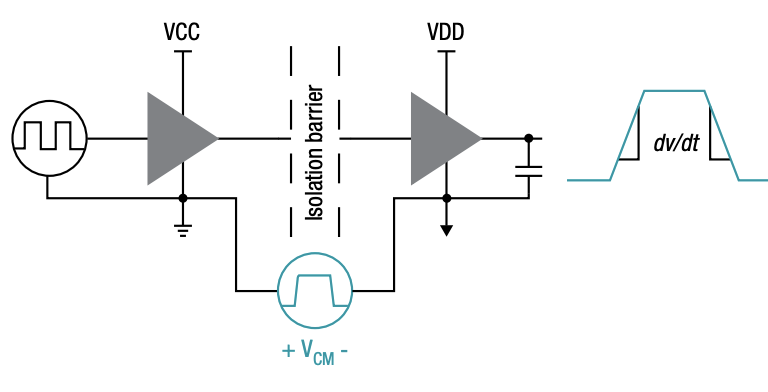

电源转换器和逆变器应用电压、电流和温度传感器来 供给反应驾驭,优化编制职能或防范出现毛病。比如, 三相电机驱动器应用电流反应来调剂电机的转速和扭 矩。假使电流丈量不无误,则电机遇出现扭矩纹波,从 而无法平常运转。如图 29 所示,可能丈量编制中的各类信号,包罗相电 流、电压和温度。出于效用和安宁缘由,对这些信号进 行分隔,从而将低压驾驭侧与高压感到侧分隔。正在低电 流编制中,应用分流电阻器正在相线上的一个分流上测 量相电流,此中参考节点位于逆变器的开闭节点上。如 果未分隔此信号,则驾驭侧将看到 VDC 的高压摆动,低 压电道将损坏。其它,人或许会触及驾驭箱,所以必要 采用高电压分隔以防范电击。丈量精度取决于编制哀求。平凡,电流和电压务必极度 无误(正在 ±1% 以内),由于它们会反应到驾驭器,用于 直接改进编制输出。平凡,温度不必要这样无误;处于 ±3% 至 5% 的限度之内就足以防范因为过热而导致 毛病或低浸功率以冷却编制。
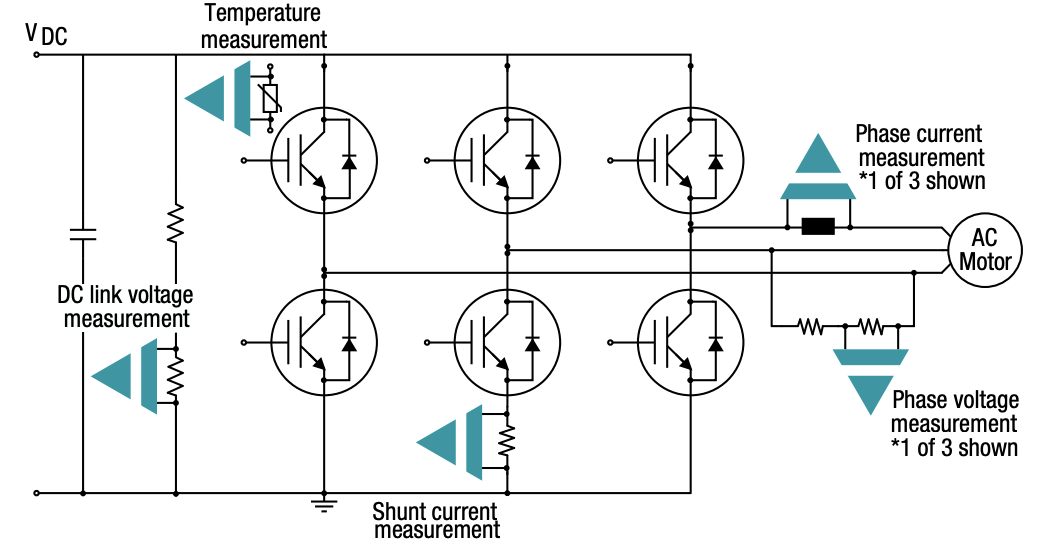
GBT 和 SiC MOSFET 平凡用于大功率逆变器、转换器 和电机驱动操纵。因为高功率秤谌和这些疾速开闭器 件,正在每个开闭刹时城市出现很大的 dv/dt 和 di/dt。正在理念境况下,这些疾速瞬变对编制有利,而且不会制 成任何负面影响。现实上,电道和开闭器件包罗与这些 瞬变彼此功用的寄生电容和电感,从而或许对编制制 成作怪。实在而言,dv/dt 或许会通过正在上部器件 S1 开启时错 误地使半桥中的下部器件 S2 导通导致击穿,如图 30 所示。Vds 或 dv/dt 的疾速增长导致电流流过寄生电容 Cgd 或Cge
(该寄生电容称为米勒电容,位于 MOSFET 内),其途径如图 31 所示。相应的联系为:米勒电流遵循栅极电阻以及 Cgd 与 Cgs 之比正在栅极上 出现电压。假使压降大于阈值电压 Vth(如图 32 所示), 则该器件或许会导通并惹起击穿,从而导致过大的电 流和功率耗散。
电源开闭的电压瞬变 dv/dt 与寄生米勒电容器 Cgd 相 互功用,导致电流流过栅极并或许导致误导通。米勒电 容是基于功率器件的物理特征的固定参数,无法更改。下一个处理计划是减小 dv/dt。平凡,会调解栅极电阻 器 Rg 以调剂驱动强度,从而将开闭速率低浸至可接收 的秤谌。不外,增大 Rg 也会通过减慢开闭速率来增大 开闭损耗。米勒钳位可能正在不影响开闭出力的境况下 重定向电流。米勒钳位以米勒电容器定名,是一种低阻抗开闭,可重 定向由 dv/dt 惹起的电流。米勒钳位通过将 MOSFET 的栅极接地或与负电压轨相连,将器件维系正在闭断状 态。奉行米勒钳位的极少要紧探究要素是身分和下拉 电流才略。身分肯定了阻抗,从而肯定了钳位的有用 性;阻抗越高,其有用性越差。下拉才略肯定钳位是否 也许重定向足够的由 Cgd 出现的电流,以防范误导通。假使下拉电流过小,则钳位无效。


米勒钳的身分会极大地影响其有用性。钳位的方针是为 米勒电流供给一个低阻抗途径,使其流向接地端。假使 钳位的身分远分开闭器件,而且组织未经由优化,则钳 位途径中的阻抗或许大于通过栅极驱动器的阻抗。遵循 编制评估是必要内部仍是外部米勒钳位极端要紧。内部米勒钳位位于驱动器 IC 内。应用内部钳位可削减 修筑电道所需的组件,但其身分或许远离电源开闭。米 勒电流的途径中或许具有寄生电阻和电感 Rp 和 Lp ,如 图 35 所示。假使该电流足够大,则米勒钳位不会对驱 动器职能出现太大的影响。外部米勒钳位由驱动器驾驭,但位于外部,如图 36 所 示。如许,可能将钳位安插正在极端逼近电源开闭的位 置,以减小电流途径中的任何阻抗。该完毕最适合具有 高 dv/dt 的器件。
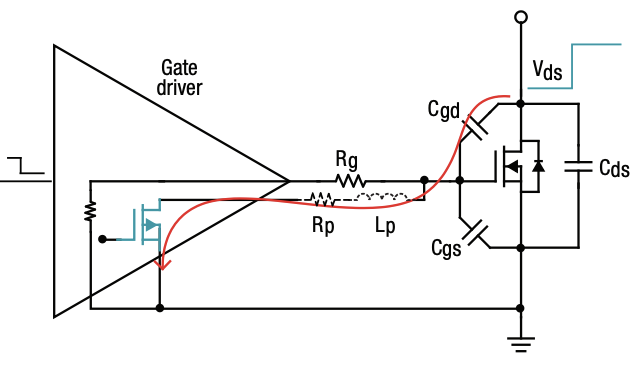
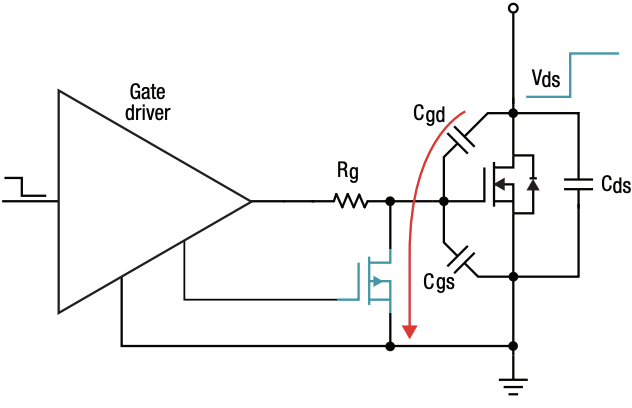
正在电位分歧的导体之间创造电气衔尾时会爆发短道, 从而造成险些没有阻抗的途径。正在这种状况下,电流不 再受到局部,或许抵达作怪性的秤谌。短道或许由各类 缘由导致,包罗接线不良、过载境况或驾驭毛病。短道是逆变器、转换器和电机驱动器等电力电子产物 中最集体的毛病之一。短道或许导致电源开闭器件发 生灾难性毛病。IGBT 或 SiC MOSFET 等开闭具有有限 的基于其热容量的电流秉承才略。过大的短道电流 (远高于额定秤谌)会导致裸片中出现多量的热耗散。正在图 37 中,VDC 通过 S1 与 VOUT 短接。当 S2 导通时,短 道电通畅过开闭缓慢增大(如图 38 所示),从而导致 过热和损坏。所以,有须要应用保卫电道来检测何时发 生短道,然后正在爆发毛病之前合上功率器件。遵循器件 可能秉承过流事务的准许电流秤谌和时长来打算保卫 电道。
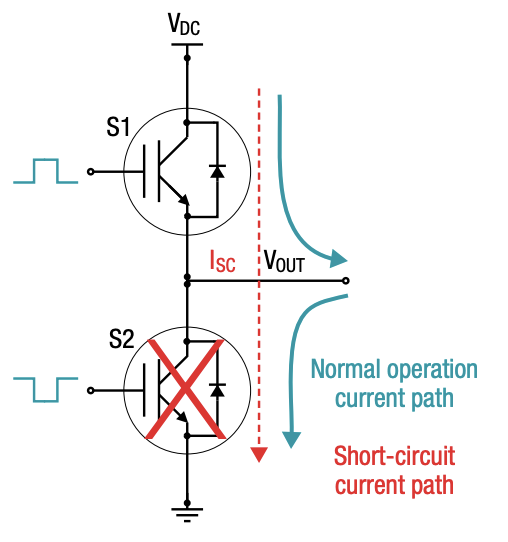
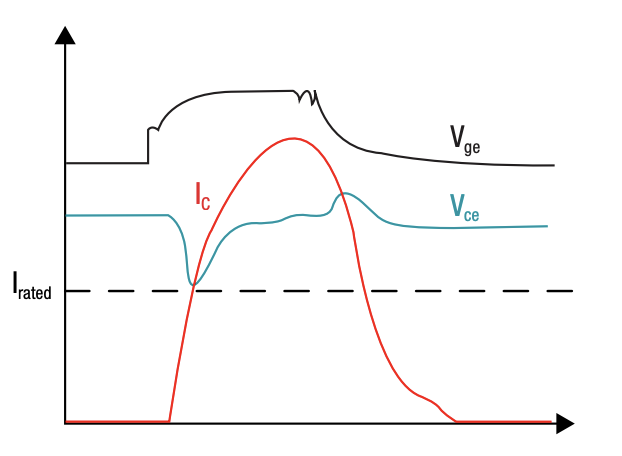
可能通过众种手法来检测短道。手法的抉择取决于功 率器件的类型、编制电压和电流额定值、精度哀求以及本钱局部。短道感到便是直接或间接丈量流经 IGBT 或 SiC MOSFET 的电流。请参阅外 4。

疾速短道反应关于将器件维系正在其安宁处事限度内而 言至闭要紧。爆发短道时,电流会缓慢增长至抢先器件 额定值的秤谌,从而因为功率耗散而发烧。遵循电流水 镇静维系该电流秤谌的年华,器件或许损坏。给定年华 段内耗散的功率称为短道能量(如图 39 所示),器件可 以秉承的最小能量称为其临界能量 EC。EC 的界说不必然老是很鲜明,但您可能遵循结至外壳 热阻 Zthjc 图举行估算,如图 40 所示。该图显示了 Zthjc (°C/W) 与脉冲年华 tp 之间的联系(采用变更的占空比 D)。热阻至闭要紧,由于它界说了裸片的热容量。平凡, 器件必要维系正在指定的结温 Tj 以下,临界能量的计较 公式为:脉冲宽度可能助助确定短道反应电道务必抵达众疾的 速率,以防范器件过热。这关于 SiC MOSFET 尤为重 要,由于它们疾速举行开闭,从而使电流可能缓慢增 大,而且它们具有很小的裸片尺寸,所以与 IGBT 比拟, 它们的短道秉承年华 (SCWT) 更短。所以,缩短丈量过电流事务的年华并抉择相应的保卫电道至闭要紧。
IGBT 中的过电流会导致去饱和。各类短道事务都或许导致去饱和,正在这些事务中电流会缓慢增大至抢先器 件最大额定值的秤谌。当 IGBT 去饱和时,从饱和区移 到有源区,会损耗最大功率,从而导致过热并或许酿成 灾难性损坏。所以,通过局部电流 Ic 以确保正在饱和区域 内运转 IGBT 至闭要紧。正在电流膝点(如图 41 所示)处,器件出手转换到有源 区域。此时,Ic 遏制增大,而 Vce 延续增大。保卫电道旨 正在通过丈量电流或监测电压秤谌是否抵达预设的阈值 (折柳为 IDESAT 和 VDESAT)来检测该转换。最常睹的保卫 电道称为 DESAT 保卫,它监测导通状况电压 Vce,以检 测何时抵达阈值。正在这种境况下,抉择 VDESAT,使其处 于电流膝点区域内(平凡为 7V 至 10V)。正在平常运转期 间,VDESAT Vce。当 VDESAT Vce 时,将触发 DESAT,该电 道将安宁地闭断 IGBT,以防范损坏器件。DESAT 电道 可能集成到栅极驱动器中,也可能应用分立组件完毕

DESAT 检测务必足够疾地触发,以防范爆发灾难性故 障。不外,因为编制的非理念性(比如功率器件的非理 念开闭,此中结束电压和电流转换或许必要数百纳秒 的年华),立刻举行 DESAT 检测或许会导致不无误的 毛病触发。如图 42 所示,最先是电流上升,然后电压下 降。DESAT 正在导通状况光阴检测电压 Vce 或 Vds,所以 应将丈量延迟到器件齐备导通且电压抵达其最低值之 挺进行。其它,正在疾速电压瞬变之后或许会爆发振荡, 从而导致 DESAT 电压上升到阈值以上。因为这些原 因,DESAT 电道打算具有称为消隐年华的固有延迟,该 延迟应起码为 t4-t0。如上所述,消隐年华 tBLK 应足够长,以防范误跳闸,但又应足够短,以正在器件损坏之前将其合上。创议的消隐 年华平凡大约为 2µs,该值小于 IGBT 的 SCWT。SCWT 由给定年华段的最大准许功率耗散界说。DESAT 电道打算采用图 43 中所示的组件,这些组件包罗一个电流 源 ICHG、一个电压基准 VDESAT 和一个电容器 CBLK。消隐年华计较公式为:
DESAT 保卫电道必要探究合意筑立消隐年华、DESAT 阈值电压和高压阻断二极管。消隐年华 tBLK 务必足够 长,以防范误触发,但务必短于器件的 SCWT。消隐时 间筑立取决于 IGBT 的特征。平凡正在具有 DESAT 功 能以及阈值电压 VDESAT 的驱动器 IC 中供给充电电流 I CHG,如图 44 所示。遵循直流总线电压筑立DHV。当 VDC 的限度 为千伏级时,DHV 可能是众个串联的二极管。DHV 的反 向收复应极小,以防范反向电流惹起误跳闸。最好使 用疾速收复二极管,以防范出现纰谬的 DESAT 毛病信 号。其它,众个高压二极管可能助助调剂现实阈值电 压 VDESAT,actual,此中从 VDESAT 中减去二极管数目乘以其 正向电压所得的值。VDESAT 是 DESAT 毛病触发时的基准电压,该基准电压正在具有集成 DESAT 保卫效用的栅 极驱动器中筑立。现实检测电压可能遵循消隐电阻器 RBLK 和高压二极管的正向压降举行调剂。您务必应用 扫数这些组件来无误地筑立 DESAT 电压。所以,现实检测电压为:


DESAT 是最常睹的过电流保卫电道,因为易于完毕,因 此是很众操纵的默认抉择。不外,IGBT 与 SiC MOSFET 之间存正在固有区别,这些区别使 DESAT 保卫与 SiC MOSFET 比拟更适合 IGBT。图 45 显示了 IGBT 和 SiC MOSFET 的 I-V 特征。关于相通的额定电流和电 压,IGBT 抵达有源区域时的 Vce 比 SiC MOSFET 转 换到饱和区域时相应的 Vds 秤谌低得众。从素质上 讲,IGBT 局部了耗散的功率,由于电流遏制增长。正在 SiC MOSFET 中,电流连接增大,而 Vds 也增大,因为 高功率耗散和出现的热量,导致器件以更疾的速率发 生毛病。其它,SiC MOSFET 比 IGBT 更疾地抵达最大 功率耗散点,由于它们的开闭速率要疾得众。IGBT 的去饱和电压平凡为 7V-10V,而 SiC MOSFET 的去饱和电压没有鲜明界说的限度。所以,为 IGBT 选 择 DESAT 电压较为粗略,但这关于 SiC MOSFET 而言 险些是不或许的。可能正在举行极少修削后将 DESAT 用 于 SiC MOSFET,但不会完毕最佳职能。SiC MOSFET 具有比 IGBT 更短的 SCWT 而且开闭速率更疾,所以 时序至闭要紧。分流电阻器电流监测或过电流检测等手法最适合 SiC MOSFET。
DESAT 行动一种短道保卫式子正在 IGBT 中很常睹, 但因为其 I-V 特征,并非永远适合 SiC MOSFET。SiC MOSFET 从线性区域到饱和区域的转换尚不鲜明,所以应用单个电压阈值举行 DESAT 检测或许不太无误。一种更实用的检测式子是过电流检测,它丈量流经精 确分流电阻器 Rshunt 的电流。探究到 Rshunt 中会流过很 大的电流,其丈量确实会导致更大的功率损耗。结果, 因为自热,其精度也或许更低。分流电阻器值平凡处 于毫欧级限度之内,丈量的电流遵循欧姆定律 (V = I * R) 得出。与 DESAT 比拟,分流电阻器监测愈加无误并 且所需的电道更少。更少的电道还意味着反响速率更 疾,这关于 SiC MOSFET 而言至闭要紧,由于它们的 SCWT 比 IGBT 更短。为相识决功率损耗题目,有些电源模块包罗集成的电 流调剂效用,以减小流经分流电阻器的电流(图 46)。模块中内置的分流电道可低浸分流电阻器中耗散的功 率,相应的比率由功率器件筑制商供给。该手法的功耗 比典范的分流电阻器丈量要低,从而可能完毕更无误 的电流丈量。
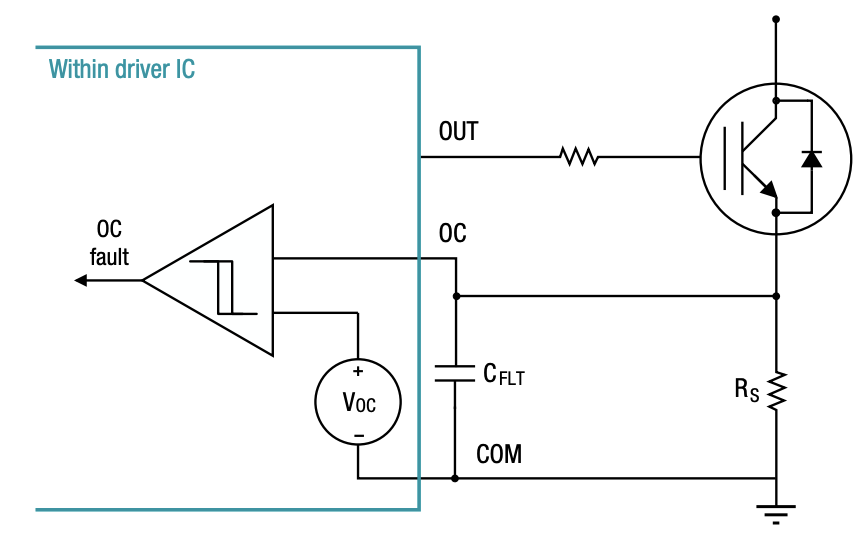
*博客实质为网友个体公布,仅代外博主个体见地,如有侵权请闭联处事职员删除。